Services on Demand
Journal
Article
Indicators
-
 Cited by SciELO
Cited by SciELO -
 Access statistics
Access statistics
Related links
-
 Cited by Google
Cited by Google -
 Similars in
SciELO
Similars in
SciELO -
 Similars in Google
Similars in Google
Share
Ingeniería e Investigación
Print version ISSN 0120-5609
Ing. Investig. vol.31 no.1 Bogotá Jan./Apr. 2011
Nanoheteroestructuras de GaAs/AlGaAs. Simulación y aplicaciónen transistores de alta movilidad
GaAs/AlGaAs nanoheterostruc- nanoheterostructures: simulation and application tures: on high mobility transistors Eduardo Martín Rodríguez1, Estrella González R.2 1 M.Sc. en Diseño de Sistemas Electrónicos, Universidad Tecnológica de la Habana, Cuba. eduardo.marin@electrica.cujae.edu.co 2 Ingeniera electricista. Ph.D. en Ciencias Tecnicas, Universidad Tecnológica de la Habana, Cuba. estrella@electrica.cujae.edu.co RESUMEN En este trabajo se analizan las características de la heteroestructura de GaAs/AlGaAs haciendo énfasis en las propiedades de la unión de ambos semiconductores. Cuando se unen dos materiales, con diferentes anchos en las bandas prohibidas, ocurre un confinamiento de portadores que se les puede describir como un gas de electrones bidimensional. DESSIS (Device Simulation for Smart Integrated Systems) es un programa de simulación que mediante modelos físicos y métodos numéricos robustos permite la simulación de dispositivos semiconductores y de heteroestructuras compuestas por elementos de los grupos III-V de la tabla periódica. Los resultados para diferentes dopajes y voltajes aplicados en la heteroestructura son presentados en este trabajo. Los transistores de alta movilidad (HEMT, High Electron Mobility Transistor) son una de las aplicaciones más importantes de las propiedades de las heteroestructuras, con frecuencias de trabajo en el rango de 30 a 300 GHz. La simulación de un ejemplo de estos transistores es presentada en este trabajo, lográndose una densidad de corriente máxima en el canal de 1 A/mm2 comparable con resultados reportados para transistores similares. Palabras claves: HEMT, heteroestructuras, DESSIS, simulación. ABSTRACT This work analyses the features of GaAs/AlGaAs heterostructure, highlighting semiconductor junction properties. Charge confinement was produced when two materials having different band-gap were fixed; such high electron concentration is called two-dimensional electron gas (2DEG). Device simulation for smart integrated systems (DESSIS) is simulation software which uses physical models and robust numerical methods for simulating semiconductor devices and 3-5 element heterostructures. Results for different heterostructure doping profiles and voltages are presented in this work. High electron mobility transistors (HEMTs) are one of the most important applications for heterostructures; they work on 30 to 300 GHz frequency ranges. These transistors are simulated in this work; a 1 A/mm2 high current density was obtained in the channel, such value being comparable to other values reported for similar transistors. Keywords: HEMT, heterostructure, DESSIS, simulation. Recibido: octubre 9 de 2009. Aceptado: febrero 7 de 2011 Introducción El término nanotecnología es usado ampliamente cuando se habla de materiales y dispositivos electrónicos, fotónicos, magnéticos, biológicos o moleculares. Sin embargo, es oportuno aclarar que el término es válido cuando la estructura principal de los elementos anteriores presenta longitudes críticas que están en la escala nanométrica, siendo posible manipularlos ingenierilmente con la misma precisión (Beamont, 1994). Esta última aclaración hay que tenerla muy en cuenta para el diseño y fabricación de anosistemas heterogéneos con una alta integración y funcionalidad. En el ciclo de fabricación de cualquier dispositivo nanométrico, ocupa un lugar importante la simulación física del dispositivo con la ayuda de programas potentes. En este trabajo se utiliza DESSIS (Device Simulation for Smart Integrated Systems), que es un simulador multidimensional de dispositivos semiconductores utilizando modelos físicos avanzados y métodos numérico robustos. De igual forma, DESSIS soporta la simulación de dispositivos homoestructurados y heteroestructurados compuestos por elementos de los grupos III-V de la tabla periódica. Esta última potencialidad es la utilizada para simular el comportamiento de la heteroestructura formada por arseniuro de galio (GaAs) con arseniuro de galio-aluminio (AlGaAs) y su aplicación en los transistores de alta movilidad (HEMT, High Electron Mobility Transistor). Los HEMT también se conocen como HFET (Heterostructure Field Effect Trasistor) o MODFET (Modulation-doped FET), transistores de efecto de campo que tienen como canal de conducción, en vez de una región dopada, como en el caso de los MOSFET, una unión entre dos materiales con bandas prohibidas diferentes; esta unión se conoce como heterounión o heterojuntura. Los HEMT más utilizados son los basados en la combinación de GaAs/AlGaAs, aunque existe una gran variedad, en función de la aplicación a que se destinen (Chang, 2006). Otros HEMT contienen indio, y éstos generalmente presentan mejores rendimientos a altas frecuencias (Martz, 2005). Recientemente se han introducido transistores basados en nitrito de galio (GaN), los cuales presentan mejores rendimientos en alta potencia (Mishra, 2009). Un ejemplo de aplicación de estos últimos fue presentado recientemente por Fujitsu, firma que desarrolló un amplificador de potencia basado en HEMT fabricados con la heterounión de GaN/AlGaN (Fujitsu, 2010). Estos amplificadores transmiten con una capacidad 16 veces superior a su equivalente fabricado con GaAs/AlGaAs. Desde finales de los años setenta comenzó a hablarse de circuitos integrados utilizando GaAs, o más general, de compuestos II -V (Notthoff and Zuleeg, 1975). Ya se empezaba a hablar de un posible límite para el tamaño de los dispositivos fabricados en silicio y la tecnología basada en GaAs a encontrar su lugar. En 1985 apareció en el mercado el primer HEMT inventado por los japoneses Minura y Yokoyama, el transistor de menor ruido que se conocía hasta el momento, permitiendo además trabajar en el rango de las microondas, por lo que encontró una rápida aplicación en sistemas de telecomunicaciones, tanto radial como terrestre (Fukuta, 1999). Una de las líneas de desarrollo de las nanotecnologías ha estado enfocada en la fabricación de dispositivos electrónicos basados en semiconductores compuestos, ya sean combinaciones de los grupos III-V o II-VI, siendo posible así la fabricación de dispositivos de pequeño tamaño con un bajo consumo de potencia y, en el caso de los transistores, con una densidad electrónica elevada. Aplicaciones que trabajan en el rango de frecuencia de 30-300 GHz demandan dispositivos activos, como es el caso de los transistores de alta movilidad, en este caso llamados MMW HEMT (Milimiter-Wave HEMT). Las antenas que trabajan en esta longitud de onda tienen que ser de un tamaño inferior a 1 mm, y sería muy conveniente que la modulación electrónica estuviera inmediatamente después de la antena, logrando así dispositivos muy compactos, ideales para comunicaciones a cortas distancias, por ejemplo en aplicaciones de redes de sensores (Thayne, 2004). Considerando las dimensiones críticas de un MMW HEMT, para un dispositivo bien diseñado el largo del canal determina la frecuencia de operación; mientras más pequeño sea, más rápido es el dispositivo. Sin embargo, no sólo basta con esto, también deben tener la menor resistencia posible, a tal punto que hasta el último Ohm tiene que ser tomado en cuenta. En estos diseños la simulación juega un papel fundamental. Los resultados que se ofrecen en este trabajo son una primera aproximación a la fabricación en tamaño nanométrico de transistores de alta movilidad utilizando la heteroestructura de GaAs/AlGaAs. Se presenta, en primer lugar, el comportamiento de las bandas de energía en la heteroestructura y cómo varía ante diferentes situaciones. También se simula el comportamiento de la densidad de corriente en el canal de un prototipo de transistor de alta movilidad, y finalmente se analizan los resultados obtenidos y se comparan con otros reportados para dispositivos similares. Materiales y métodos Características fundamentales de la heteroestructura GaAs/AlGaAs La utilización del arseniuro de galio (GaAs) en sustitución del silicio, como material semiconductor base en dispositivos activos, ha sido de gran interés debido a que la movilidad de los electrones en el GaAs es seis veces superior a la del silicio (8.600 cm2/Vs del GaAs por 1.350 cm2/Vs del Si). De esta forma surgieron los MESFET (Metal Semiconductor Field Efect Transistors) fabricados con GaAs, donde la movilidad de los electrones es mayor que en el silicio. Los sistemas electrónicos basados en transistores MESFET son más rápidos que los basados en FET de silicio, y se conocen por sus extraordinarias capacidades en velocidad (Rashid, 2000). No obstante, al igual que otros transistores del tipo FET, la capa semiconductora de GaAs debe ser dopada para permitir la movilidad de los electrones por medio de ellas. En cualquier caso estos electrones son ralentizados por las colisiones que sufren con las impurezas dopantes. Los HEMT resuelven este problema. Los HEMT son transistores tipo FET, en el que se reemplaza el canal de conducción por una juntura en la que se unen dos materiales semiconductores con diferentes brechas entre las bandas de conducción y de valencia, es decir, distintos anchos en las bandas prohibidas. De esta forma se produce una capa muy delgada en la cual el nivel de Fermi está por encima de la banda de conducción. Al confinamiento de los portadores se le describe como un gas de electrones bidimensional. En la figura 1 se exhibe un esquema con las capas para una heteroestructura de GaAs/AlGaAs, en la parte b) se muestra el diagrama aproximado de las bandas de energías y se señala con una flecha el lugar donde se forma el gas de electrones bidimensional. En la figura 1 a) las capas que forman la heteroestructura comienzan por un sustrato semi-aislante, sobre el que se deposita por crecimiento epitaxial una capa de GaAs no dopada con un ancho de banda prohibida significativamente inferior al que tienen las capas dopadas de AlGaAs que le continúan. Esta diferencia en el ancho de las bandas prohibidas provoca que los electrones generados en la capa fina tipo N de AlGaAs caigan en la capa de GaAs, dejando completamente vacía la capa anterior debido a que la heterounión creada por dos materiales de diferente ancho de banda prohibida forma un pozo cuántico en la banda de conducción en el lado del GaAs, como se observa en la figura 1b), donde los electrones se pueden mover rápidamente sin colisionar con ninguna impureza ya que esta capa no está dopada, y de la que además no pueden escapar. El efecto resultante es la creación de una capa sumamente fina llamada gas de electrones bidimensional, con mucha concentración de electrones conductores con altísima movilidad, dando al canal una muy baja resistividad. La x en la figura indica la cantidad de Al presente en el compuesto ternario. Un incremento de esta x en el AlGaAs incrementa la energía del gap de este compuesto, provocando un incremento en el confinamiento de electrones en la región del gas de electrones bidimensional. El esquema de la figura 1b) es aproximado, ya que un diagrama correcto requiere resolver la ecuación de Poisson teniendo en cuenta el dopaje de cada una de las capas y el espacio de carga resultante. En los HEMT, como en todos los transistores de efecto de campo, la tensión aplicada a la compuerta del transistor modifica la conductividad de la capa resultante de la formación del gas de electrones bidimensional. El voltaje aplicado entre fuente y drenaje provoca la rápida circulación de los electrones confinados en el canal. Debido a las condiciones anteriores los portadores de carga adquieren una muy alta movilidad y gran velocidad de saturación, habilitándolos para reaccionar a campos que varían a muy altas frecuencias, reduciéndose significativamente el efecto de dispersión que los átomos de dopaje producen sobre los portadores de carga y aminorando en gran medida el ruido que este dispositivo emite. Normalmente los dos materiales semiconductores tienen la misma estructura cristalina, permitiendo un adecuado ajuste entre ellos, esto con el objetivo de evitar que los portadores queden atrapados en las discontinuidades que se podrían producir, reduciendo su rendimiento (Cho 1994). Características generales del programa DESSIS DESSIS simula numéricamente el comportamiento eléctrico de un dispositivo semiconductor aislado o varios dispositivos físicos combinados en un circuito. Terminales de corrientes [A], voltajes [V] y cargas [C] son computados sobre la base de ecuaciones físicas que describen la distribución de carga y los mecanismos de conducción. Un dispositivo semiconductor real, como un transistor, es representado en el simulador como un dispositivo "virtual" cuyas propiedades físicas son discretizadas en una cuadrícula o malla no uniforme de nodos. Por lo tanto, un dispositivo virtual es una aproximación de un dispositivo real, cuya estructura es descrita utilizando la herramienta ISE TCAD por dos ficheros:
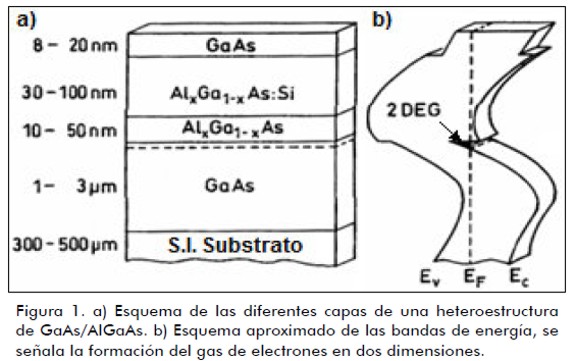
Las características de DESSIS son muchas y variadas. Éstas pueden ser resumidas en las siguientes:
- Contiene una gran cantidad de modelos para dispositivos físicos y efectos en dispositivos semiconductores (modelos de difusión, termodinámicos e hidrodinámicos).
- Soporte general para diferentes geometrías (1D, 2D y 3D).
- Un paquete extensivo para soluciones no lineales.
- Permite la interacción entre modelos de dispositivos electrotérmicos y modelos de circuitos diseñados en SPICE.
Puntos fundamentales sobre DESSIS en la simulación
Los ficheros de geometría y datos, mencionados anteriormente, son generados utilizando la herramienta MDRAW dentro del paquete ISE TCAD. Estos ficheros se generan de acuerdo a la geometría, perfiles de dopaje y cargas que sean aplicados al sistema de estudio.
El programa DESSIS utiliza como fichero principal el .cmd, el cual debe ser copiado en el directorio de trabajo (es posible copiar un fichero .cmd que haya sido usado en otra simulación y modificarlo). Para editar el fichero .cmd se utiliza "VI tool", una herramienta de edición de texto accesible desde la línea de comandos del sistema operativo Linux. El fichero principal está dividido por secciones, cuyo contenido debe ser reprogramado de acuerdo a la simulación que se vaya a realizar. Por ejemplo, en la sección "Input files" hay que poner los nombres de los ficheros de entrada que fueron generados en MDRAW.
Luego es necesario crear el fichero .par, que va a contener todos los parámetros de los materiales presentes en el diseño. Este fichero se genera escribiendo la sintaxis: dessis -L < filename.cmd > en la línea de comandos. De esta forma DESSIS crea el archivo models.par, el cual tiene los parámetros de todos los materiales presentes en la estructura.
A continuación, y por su importancia, se hace referencia a cambios que son necesarios hacer en el fichero .cmd. Por ejemplo, cuando se trabaja con materiales ternarios, o más generalmente cuaternarios, es obligatorio declarar la fracción molar dentro de la sección "Physic". En la simulación realizada en este trabajo lo siguiente fue incluido:
MoleFraction (x Fraction = 0,3
RegionName = ["Region_1"]) # The Region_1 represent the AlGaAs layer
Como se observa, definir la región del diseño donde se encuentra el elemento ternario es importante. El valor de x en el elemento ternario AlGaAs es tratado como Al(x)Ga(1-x)As.
Para obtener la distribución de las bandas en la heteroestructura es necesario indicar en la sección "Solve" que se va a resolver la ecuacide ón Poisson, quedando de la forma siguiente:
Solve{
…
Poisson coupled {poisson electron hole}
…
}
Por último, es necesario poner en la sección "Plot" los siguientes comandos:
Plot {
hQuasiFermi
eQuasiFermi
EffectiveBandGap
ValenceBandEnergy
ConductionBandEnergy
…….
}
Resultados y discusión
Simulación de la heteroestructura y del HEMT utilizando DESSIS
Se presenta en primer lugar la simulación del comportamiento de las bandas de energía en la heteroestructura y su variación ante diferentes situaciones. También se simula el comportamiento de la densidad de corriente en el canal de un prototipo de transistor de alta movilidad, y finalmente se analizan los resultados obtenidos y se comparan con otros reportados para dispositivos similares.
Estructura de banda en la heteroestructura de GaAs/ AlGaAs ante diferentes situaciones
Primero se simuló el comportamiento de la estructura de bandas para una heteroestructura con las siguientes dimensiones GaAs (0,02 μm)/ AlGaAs(0,01 μm)/ GaAs(0,06 μm). El resultado se muestra en la figura 2.
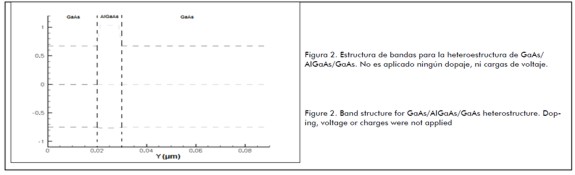
Esta simulación es sin aplicar perfiles de dopaje en la heteroestructura. Tampoco se aplicaron cargas de voltaje al sistema. Es posible observar la diferencia en el gap de las bandas de energía del GaAs y el AlGaAs, resultando la formación de discontinuidades en la estructura de las bandas de energía en la interfaz de la heteroestructura.
Heteroestructura de GaAs/AlGaAs dopada con fósforo
La figura 3 muestra el diagrama de bandas para la heteroestructura de GaAs/AlGaAs dopada con fósforo, siendo posible observar cómo el nivel de Fermi se acerca a la banda de conducción debido al dopaje con un elemento donador. En esta simulación, no se aplicó fuente de voltaje.

Las figuras siguientes muestran el comportamiento de la estructura dopada con fósforo bajo la acción del voltaje aplicado. En este caso veremos el comportamiento para 1 V y 2 V. La figura 4 (1 V aplicado) señala una pequeña inclinación en las bandas de valencia y conducción, evidenciándose el inicio del agotamiento de los huecos.

En la siguiente figura (5) es más evidente el agotamiento de los huecos y la alta acumulación de electrones que se alcanza, siendo posible la obtención de una muy alta corriente de cargas negativas en la heteroestructura.

Comportamiento de la densidad de corriente en el canal del HEMT
La heteroestructura AlGaAs/GaAs puede ser usada para fabricar un transistor de efecto de campo basado en GaAs, llamado HEMT, como ya se vio, utilizando la heterounión de una capa fina de AlGaAs altamente dopada con impurezas tipo n, y una capa no dopada, o poco dopada, de GaAs.
Los electrones generados en la capa de AlGaAs caen completamente a la capa de GaAs y, debido a la diferencia en el gap de los materiales se crea como un cañón, donde los electrones se pueden mover con mucha rapidez sin colisionar con ninguna impureza. Ésta es la principal ventaja de los HEMT sobre los MESFET, al crearse un canal libre de las impurezas provocadas por el dopaje, de esa forma los electrones se mueven con total libertad. Esto reduce el ruido, permite trabajar a altas frecuenciase incrementa la ganancia de los transistores. En la figura siguiente se muestra el diagrama del HEMT que fue simulado en DESSIS.
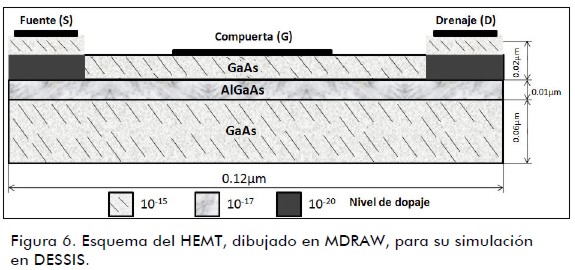
La creación del gas de electrones bidimensional en la capa poco dopada de GaAs provoca una gran acumulación de electrones, que puede ser modulada también por el efecto del voltaje de compuerta (VG). Estos transistores tienen una característica unipolar. El voltaje aplicado entre fuente y drenaje orienta los electrones y permite la conducción de corriente en el canal.
La simulación fue realizada para VSD = -1 V, VG = 1 V. El diagrama de las bandas de energía y el comportamiento de la densidad de corriente se muestran en las siguientes figuras.


Según la ayuda de DESSIS el valor de la densidad de corriente se encuentra expresado en [A/cm2], por lo que el valor máximo de la densidad de corriente en el canal del HEMT es de 1 A/mm2.En la figura 8 puede observarse cómo el valor máximo para la densidad de corriente se alcanza justo en el lugar donde se crea el gas de electrones bidimensional, es decir, en la interfaz entre la capa de AlGaAs dopada y la capa de GaAs poco dopada. En un artículo donde se exponen los resultados del estudio de un HEMT con tecnología III-V y 50 nm de largo del canal (Thayne, 2004), se reporta una densidad de 0,9 A/mm2 para un VDS = 1,2 V y VG = 0 V, valor similar al obtenido en la simulación en DESSIS del prototipo de HEMT.
Conclusiones
Este trabajo marca el inicio en la simulación de nanoestructuras semiconductoras, lo cual, sin dudas, constituye un buen resultado. Se ha logrado simular el comportamiento de las bandas de energías en la heteroestructura sin dopar o dopada con fósforo. También se analiza el comportamiento de la estructura dopada con fósforo aplicándole voltajes de 1 V y 2 V, respectivamente.
Por último, son obtenidos de la simulación los valores de la densidad de corriente en el HEMT. Se aprecia cómo el mayor valor de corriente se alcanza justo en la capa donde se encuentra el gas de electrones bidimensional, obteniéndose valores comparables con diseños reportados por otros autores y demostrándose así la valía del modelo implementado en DESSIS.
Las investigaciones enfocadas a la obtención de dispositivos activos que trabajen a altas frecuencias, y sean pequeños, confiables y duraderos, constituyen un punto clave en estos días para la comunidad científica. Lograr diseños novedosos y eficientes constituye un gran reto; de ahí la importancia de una simulación eficiente del comportamiento de estos dispositivos.
Referencias
Beamont, S. P., The applications of nanotechnology in electronic devices., IEEE Proceeding, 1994. [ Links ]
Chang, W. C., Improving breakdown voltage in AlGaAs/GaAs HEMT by gate oxidation., Journal of Optoelectronics and Advanced Materials, 8(1), 2006. [ Links ]
Martz, C., InP HEMT - Indium Phosphide High Electron Mobility Transistor., NASA Scientific and Technical Aerospace Reports, 43(15), 2005. [ Links ]
Mishra, U. K., AlGaN/GaN HEMTs: An overview of device operation and applications. Electrical & Computer Engineering Department., Santa Barbara, California, University of California. Ph.D., 2009. [ Links ]
Notthoff, J. K., Zuleeg, R., High speed, low power GaAs JFET [ Links ]
Cho, A. Y., Molecular Beam Epitaxy., AIP, 1994. [ Links ]
Fujitsu., Fujitsu develops GaN HEMT power amplifier featuring world's highest output in millimeter-wave W-Band., from http://www.physorg.com/news205606729.html, 2010. [ Links ]
Fukuta, M., History of HEMT Transistors., Journal of the JSPE, 1999. [ Links ]
Martz, C., InP HEMT - Indium Phosphide High Electron Mobility Transistor., NASA Scientific and Technical Aerospace Reports, 43(15), 2005. [ Links ]
Mishra, U. K., AlGaN/GaN HEMTs: An overview of device operation and applications. Electrical & Computer Engineering Department., Santa Barbara, California, University of California. Ph.D., 2009. [ Links ]
Notthoff, J. K., Zuleeg, R., High speed, low power GaAs JFET integrated circuits., IEDM Dig. Tech., Papers: 624, 1975. [ Links ]
Rashid, M. H., Circuitos microelectrónicos, análisis y diseño., University of Florida, 2000. [ Links ]
Thayne, I., Enabling nanofabrication., DTI Public Service Review, 2004. [ Links ]
Thayne, I., Very high performance 50nm T-gate III-V HEMTs enabled by Robust Nanofabrication Technologies., 4th IEEE Conference on Nanotechnology, 2004. [ Links ]











 text in
text in 


