Introducción
Los nitruros a base de metales de transición presentan propiedades físicas similares a las de los ceramicos y metales simultaneamente. Entre estos materiales, el nitruro de tantalio (TaN) destaca por su gran solidez, durabilidad y resistencia a la corrosion; así como también por ser químicamente inerte, lo que ha permitido su aplicación en condiciones extremas de temperatura y presión. Debido a su alta dureza, TaN también es utilizado como recubrimiento fino de herramientas de perforation, tales como brocas, herramientas de corte como las cizallas, llantas para la nieve y mas recientemente en dispositivos para implantes biomecánicos y hemodinámicos [1-3]. Dado que las propiedades ópticas, eléctricas, térmicas, magnéticas y electrónicas del TaN dependen fuertemente del método y las condiciones de deposition [4-7], en las últimas décadas, ellas han sido personalizadas para una gran variedad de aplicaciones en la fabricación de dispositivos electrónicos [8-11].
Las películas delgadas de TaN son convencionalmente depositadas por la técnica de pulverization magnética reactiva DC que es un método de deposition física en fase de vapor (PVD) [12-18], el cual usualmente permite obtener muestras con mayor pureza que las obtenidas por métodos de deposición química en fase de vapor (CVD) [19, 20]. Bajo esta técnica, las propiedades y estequiometría de las películas depositadas, dependen de factores fundamentales como la composición química del plasma de trabajo, la corriente en la superficie del ánodo o blanco, la temperatura del sustrato, la distancia de separación entre el blanco y el sustrato o el tiempo de deposition [21,22]. El índice de refracción real n y el coeficiente de extinción k del índice de refracción complejo ñ = n + ik de películas delgadas de TaN puede ser medido mediante la técnica de elipsometría espectral, la cual ha sido usada extensamente en la determination de propiedades ópticas de muchos materiales [23-25].
Otros investigadores [26-29] reportaron que utilizaron elipsometría espectral (SE) para determinar los índices de refraccion y constantes ópticas de películas delgadas de TaN, SnO2, TaNx y VN, a partir del anaílisis de los datos por SE, que se simularon repetidamente utilizando el modelo Drude-Lorentz.
El objetivo del presente trabajo es medir el índice de refracción ñ de películas delgadas de TaN en el rango visible e infrarrojo depositadas sobre sustratos de silicio tipo n a temperaturas de 473 K, 573 K y 673 K, así como la rugosidad de las películas para cuantificar y analizar su evolución con la temperatura del sustrato. Las películas fueron depositadas mediante la técnica de pulverización magnética reactiva DC, manteniendo la relación N2/Ar constante durante todo el proceso, y el espectro visible e infrarrojo cercano de ñ es medido con un elipsómetro. Además, la estructura cristalina de nuestras películas es caracterizada con un difractómetro de rayos X (XRD), mientras que sus composiciones químicas son identificadas con la espectroscopia de electrones Auger (AES). Las mediciones mostraron variaciones significativas de ñ con la temperatura del sustrato, lo cual indica que el índice de refracción de películas de TaN puede ser personalizado cambiando la temperatura del depósito. Los resultados obtenidos pueden ser de utilidad en el diseño y fabrication de recubrimientos duros en herramientas de corte y cizalladura (sellado de enlatados, corte de metales, tecnologías para la perforación de pozos y túneles), y en dispositivos hemodinámicos, (válvulas cardíacas y prótesis para segmentos óseos) [30-33].
Síntesis de las muestras
Se depositó una película delgada de Ta puro, sobre un sustrato de vidrio (lámina portaobjeto) por un tiempo de 15 minutos, para tener una muestra de referencia de los picos de difracción de este material. Se hizo un pre-sputtering por 120 segundos, para limpiar el blanco de cualquier impureza. Los parámetros de deposición de esta muestra fueron: Presión de fondo 1.7x10-5 mbar, presión con Ar 6.2x103 mbar, temperatura del sustrato 473 K, intensidad de corriente 400 mA, voltaje 100 VDC.
Se depositaron tres películas de TaN sobre obleas de silicio (Si) de dirección preferencial (100) para el TaN a 473 K y con dirección preferencial (111) para el depósito de TaN a 573 K y 673 K, respectivamente por el método de pulverización magnética reactiva con corriente directa DC, cuya configuración experimental se muestra en la figura 1. Esta técnica consiste en generar un plasma a partir de un gas inerte como el argón de masa atómica elevada y una descarga eléctrica entre dos electrodos dentro de una cámara de vacío, conformando una nube de partículas ionizadas que luego son bombardeadas en el blanco con energías suficientes para arrancar, extraer o expulsar a los átomos constituyentes del material bombardeado, para pasar a la fase de vapor. El campo magnético creado por los imanes sirve para afectar las trayectorias de electrones secundarios producidos en el bombardeo del blanco. Estos electrones adoptan trayectorias helicoidales alrededor del campo magnético incrementando así la generación de nuevas partículas ionizadas en el plasma y con ello aumentar la velocidad de deposition de la película. Las obleas de Si (111) con una capa de SiO2 fueron sometidas a un baño químico de ácido fluorhídrico al 40 % para extraer la capa que las cubría mientras que para las obleas de Si (100) no fue necesario hacer esto; luego se las sometió a una limpieza con alcohol y a un baño ultrasónico por tres minutos. La deposición se realizó a partir de un blanco de tantalio con 3 pulgadas de diámetro y pureza de 99.95 % en una atmósfera de nitrógeno y argón. Cada sustrato fue colocado horizontalmente, a 8 cm por encima del blanco y la pulverización catódica se llevó a cabo ortogonalmente en la cámara de vacío. El voltaje aplicado fue de 100 VDC, la intensidad de corriente eléctrica de 400 mA, y la potencia de la fuente de 40 W. El gas reactivo fue N2 con una presión parcial de 3.5x10-4 mbar y una presión total (Ar + N2) de 6,05x10 3 mbar, para todas las muestras. El tiempo de deposición de cada muestra fue de 10 minutos, a las cuales se les realizó un pre-sputtering de 60 segundos con una presión de argón de 5.7x10-3 mbar. Para facilitar el crecimiento de la película de TaN, se depositó una capa muy delgada precursora de tantalio puro por solo 30 segundos para la primera muestra y de solo 60 segundos para las otras dos muestras a igual presión de argon. En la tabla 1 se muestran los parámetros considerados en este estudio para la deposición de las películas delgadas de TaN.

FIGURA 1 Esquema del montaje experimental utilizado para la deposición de películas delgadas por el metodo de pulverización catódica por magnetron reactivo DC.
Caracterización estructural, morfológica y óptica
La estructura cristalina de las tres muestras depositadas se analizo con un difractómetro de rayos X marca Rigaku, modelo Miniflex II con una sensibilidad del 1 % y una radiación de Cu-Kα 1 de longitud de onda 1.540562 A. Esta técnica permite conocer la estructura microscópica de una muestra, es decir, las posiciones que ocupan en el espacio los átomos que forman el material; el orden conjuntamente con la simetría y periodicidad que presentan estos átomos determinan las propiedades físicas y químicas que tienen estas películas delgadas. Para identificar los planos cristalográficos, se hace incidir un haz de rayos X sobre la muestra con un angulo de barrido entre 30° - 80° y se mide la intensidad del haz difractado en función del ángulo 29. La position de los máximos de intensidad permite identificar los planos que los produce lo que a su vez permite determinar la estructura cristalina, la distancia entre planos, los parámetros de red y el tamaño de grano.
Los análisis AES se han llevado a cabo en una cámara de vacío en condiciones de ultra alto vatio con una presión base de 10-9 mbar, obtenidas mediante la acción combinada de una bomba iónica (Riber modelo 401 150) y una bomba de sublimación de titanio (Leybold-Heraeus NV12). La presión se mide con un vacuómetro (IONIVAC IM 510). Una bomba turbomolecular Leybold Turbovac 151 (151 l/s) apoyada por una bomba rotatoria Leybold Trivac D4B (4 m3/h). El cañon de electrones esta constituido de un alambre de tungsteno por el cual fluye una corriente de 2 A y en las condiciones tópicas de trabajo se obtienen emisiones entre 400 - 1000 µA. El haz de electrones puede ser acelerado con energías desde 0.5 kV hasta 5.0 kV, mediante una pistola de electrones Perkin Elmer 11-010. Los electrones Auger emitidos por la muestra son colectados por un detector que discrimina en función de la energía mediante un analizador cilíndrico (CMA) de paso simple. La rampa de voltaje del CMA esta modulada por una señal sinusoidal de amplitud pequeña (1,25 V) y una frecuencia de 1.6 kHz. Luego del analizador la señal esta modulada a dicha frecuencia, la cual se amplifica en un CEM (Channel Electron Multiplier).
La caracterización morfológica se realizo mediante un microscopio electrónico de barrido (SEM) marca TESCAN, modelo Vega II-LMU, con filamento de tungsteno, una resolution en bajo vacío, modo BSE de 3,5 nm a 30 kV, corriente de prueba de 1,0 pA a 2/ A que aplica electrones secundarios (SE) para las imágenes y electrones retrodispersados (BSE) para el microanálisis. El microanalizador marca OXFORD, modelo Penta FETx3, que utiliza la técnica de microanálisis por EDX, con una sensibilidad mayor de 0,1 %, capaz de detectar elementos químicos desde el boro hasta el uranio.
La rugosidad fue medida usando un microscopio de barrido por sonda SPM, marca Bruker, modelo Dimensión Edge AFM (Microscopio de Fuerza Atómica), provisto de un cantilóever RTESP de antimonio dopado con silicio a 0.01-0.025 ohm-cm, radio de curvatura de la punta 8 nm, nuómero de puntos de datos por línea, 512x512 pixeles, frecuencia de barrido 10000 Hz, constante elástica k = 40 N/m y una frecuencia de 300 kHz en el modo de barrido de contacto intermitente (Tapping mode). La recoleccióon y procesamiento de los datos se realiza con el software Nanodrive V8.02. Para calcular las rugosidades se usó el programa Nanoscope analysis.
La elipsometría es una técnica no destructiva que es utilizada para determinar entre otras propiedades, el espesor de las películas, y sus índices de refracción. Consiste en medir un cambio en la polarization de la luz que se refleja o se transmite a partir de la estructura cristalina de un material en estudio; en general, el estado de polarización saliente es el de una onda elíptica. Cualquier elipse puede caracterizarse por dos valores, uno es la excentricidad y el otro la orientación respecto a los ejes coordenados, como se muestra en la figura 2. Así, para un angulo de incidencia previamente fijado, se miden los parámetros elipsometricos $ y A en un intervalo determinado de longitudes de onda. El índice de refracción n = n + ik complejo de las películas de TaN se determino mediante un elipsómetro marca Woollam-VASE (elipsometría espectroscópica de angulo variable), modelo M-2000 DI con un rango de 193 nm a 1690 nm, es decir, opera con longitudes de ondas visibles e infrarrojos cercanas.
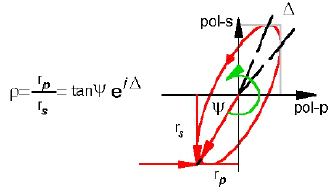
FIGURA 2 Estado de polarizacion elíptica de una onda reflejada o transmitida a traves de la estructura cristalina de un material.
El principio de funcionamiento de la elipsometría consiste en producir un cambio en la polarización de la luz que se refleja o se transmite dependiendo de la función dieléctrica del material, tal como se muestra en las figuras 3 y 4. El cambio de polarización se representa mediante una relación de amplitud $ y una diferencia de fase Δ. A partir de psi y delta, se relacionan con la razón de coeficientes de Fresnel, que a su vez están relacionados con los índices de refracción de las capas [34].

FIGURA 4 Reflexión de un haz de luz incidente polarizada linealmente. La reflexión produce un haz elípticamente polarizado [36].
Una vez obtenido el espectro elipsometrico de la película delgada (psi, delta), se realiza una simulación de propagación de ondas en medios continuos, emulando las condiciones experimentales: una onda electromagnética que se propaga en aire, arriba a la capa depositada, viaja a través de ella, pasa al sustrato. En cada interfaz se refleja y transmite. La suma de todas las ondas reflejadas es la que mide el elipsometro. Calculando el coeficiente de reflexión en las dos polarizaciones, haciendo la razón entre ellas y se calcula la (psi, delta) para cada color. Estos valores calculados se comparan con los experimentales. En la medida en que se parezcan más los valores experimentales y calculados, mejora la confianza en que nuestro modelo reproduce al experimento.
Se puede hacer la comparación punto a punto o emplear una relación de dispersión, que hay muchas, conectando el índice de refracción como una función del color, n = f (color).
En nuestro caso usamos el modelo del oscilador amortiguado de Lorentz [28].
Variando la amplitud del oscilador (A), la frecuencia central (ω 0) y ensanchamiento (Γ). Conocido epsilon, la funcion dieléctrica, se determina n y k, usando la relación ε = ñ2. El procedimiento y formulas usadas para determinar n y k se especifican en los artículos [23,25]. En la figura 5 se muestra la dependencia de la función dieléctrica real e imaginaria en función de la frecuencia del fotón incidente sobre la muestra.
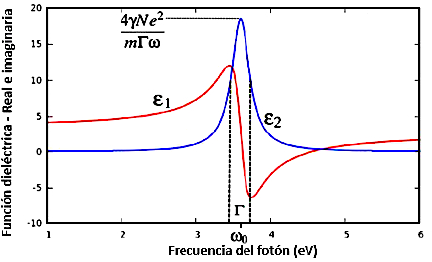
FIGURA 5 Función dieléctrica real e imaginaria en función de la frecuencia del fotón incidente [37].
Resultados y discusión
Estructura cristalina y parámetros de red
El patrón de difracción de la película de Ta puro sobre un sustrato de vidrio, obtenido del análisis XRD mostraron que para una temperatura del sustrato de 473 K las orientaciones de los planos cristalinos son (200), (330) y (400) tal como se muestra en la figura 6 y concuerda con lo reportado por otros investigadores que usaron sustrato de silicio (100) [28].
En el caso de las películas de TaN, los patrones muestran que a medida que se incrementa la temperatura del sustrato, entre 473 K a 673 K la estructura cristalina es fcc, con diferentes direcciones de los planos cristalográficos, lo cual corrobora que son poli cristalinas, esto se muestra en las figuras 7 y 8. En la figura 7, se puede observar que cuando la temperatura del sustrato se incremento a 473 K, las orientaciones preferidas son (001), (111) y (200); en la figura 8a, se observa que cuando se incremento a 573 K las orientaciones preferidas son (111), (200), (311) y (222) y en la figura 8b que cuando se incremento a 673 K se presentaron direcciones preferenciales según los planos (111), (200), (220), (311) y (222).

FIGURA 6 Patron XRD de película delgada de Ta puro sobre un sustrato de vidrio a 473 K. Se observan varios planos cristalinos preferenciales.

FIGURA 7 Patron XRD de película delgada de TaN depositada a una razín N 2 /Ar constante, sobre un sustrato de Si (100) a 473 K.
Estos resultados tambióen fueron encontrados por otros investigadores en sendos trabajos de investigacióon realizados con anterioridad [7,23,33,34]. En estos patrones de difraccion tambien se observo un pico para el silicio (Si), sin embargo, es necesario indicar que los picos del silicio aparecen en diferentes posiciones debido a que para obtener la pelócula de TaN a 473 K de la figura 7 se uso un sustrato de silicio (100) en cambio para obtener las películas de TaN a 573 K y 673 K de la figura 8a y 8b respectivamente, se usaron sustratos de Si (111). Los parómetros de red se obtuvieron a partir de los datos de la difractometró de rayos X y fueron los siguientes: para el silicio sistema cristalino cubico, a = 6,636 Å, volumen de celda = 292,23 A3, para el TaN, a = 4,3399 Å3, volumen de celda =81,74 Å3.
Composición química de las películas
De acuerdo a los resultados de espectroscopia por electron Auger (AES), la composition química de la superficie de las películas de TaN depositadas, está conformada principalmente por tres tipos de elementos químicos, tantalio (Ta), nitrógeno (N) y oxígeno (O), habiéndose encontrado también en pequenas concentraciones la presencia de argon (Ar) y carbono (C), tal como se muestra en la figura 9 del espectro Auger de la muestra depositada a 673 K. Se encontro que las capas depositadas en este caso contenían, tantalio en alto porcentaje (64.7%), nitrógeno (27.6%), oxígeno (5.8%), carbono (1.2%) y argon (0.7%), proporciones reducidas en las dos últimas producto de la contaminación dentro de la cámara de vacío. La presencia de oxígeno independientemente del flujo de N2 y las propiedades del sustrato usado [38], se debe al incremento de la temperatura, lo cual va a influir en el comportamiento del proceso de oxidación de las películas a través del tiempo.
Morfología superficial y rugosidad
Las micro imágenes de la figura 10 de microscopía electrónica de barrido (SEM) revelan cambios, aunque muy moderados entre las películas TaN obtenidas 473 K y 573 K en cambio con la de 673 K si es más notoria, en la morfología de la superficie en función de la temperatura del sustrato. En todos los casos el aumento de las microfotografías es de 2 kX. En la figura 10 (a) se puede observar la morfología de las películas depositadas a temperatura de 473 K, en la figura 10 (b) para temperatura de 573 K y en la figura 10 (c) para temperatura de 673 K, mientras los demás parámetros permanecen constantes. Podemos ver a simple vista que a medida que se incrementa la temperatura del sustrato, el tamaño del grano también aumenta, lo cual se puede comprobar aplicando la ecuación de Scherrer:
Donde, D es el tamaño del cristalito o del grano, K es el factor de forma del cristal e igual a 0.9, λ es la longitud de onda del haz de rayos X incidente, θ el angulo de difracción y β full width at half máximum-FWHM) es el ancho a la altura media del pico de difracción mejor definido. Para determinar el tamaño de grano en cada muestra tomamos en cuenta las intensidades de los dos mejores picos en cada patrón de difracción obtenido para cada muestra en particular.
En la tabla 2 se muestran los resultados obtenidos. Podemos observar que para la temperatura de 473 K el tamaño promedio del grano es 78.265 Å, para 573 K es de 87.534 Å y para 673 K de 119.719 Å, lo cual demuestra que a medida que aumenta la temperatura del sustrato, el tamaño de grano permanece casi constante hasta cierta temperatura y luego se incrementa bruscamente, lo cual va a influenciar no solo sobre la morfología superficial sino también sobre la rugosidad de la muestra.
TABLA 2 Tamaño de grano o de los cristalitos de películas delgadas de TaN, sintetizadas a diferentes temperaturas del sustrato, por el método de pulverización magnética reactiva DC.

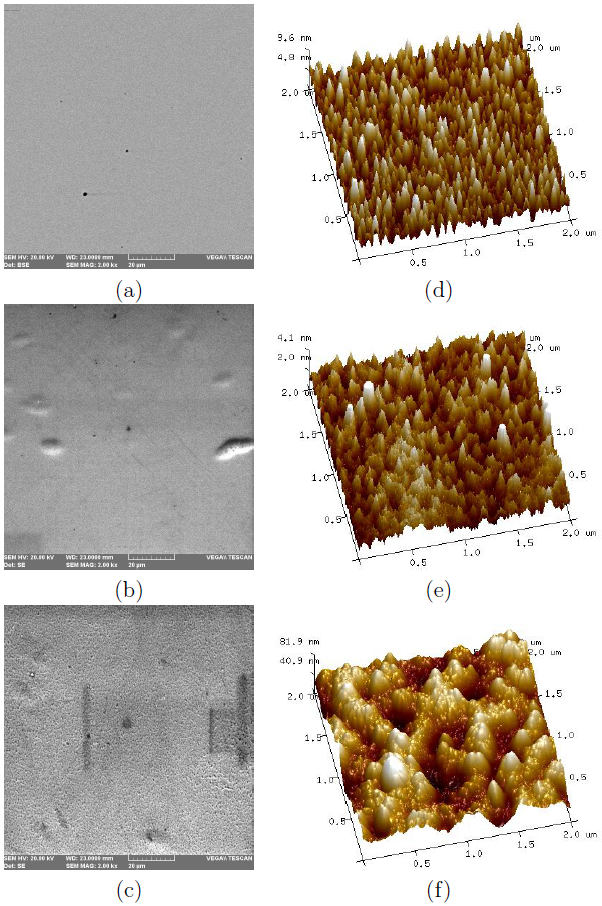
FIGURA 10 Resultados del SEM y AFM tridimensional de películas delgadas de TaN, depositadas por pulverización magnética reactiva DC. (a) y (d) a 473 K, (b) y (e) a 573 K y (c) y (f) a 673K. Se observa que el tamaño de grano se incrementa a medida que la temperatura aumenta.
Este tipo de comportamiento, ha sido descrito Hantechzadeh y Mortazavi (2012) [18], quienes encontraron que la altura media del grano de las películas delgadas de TaN disminuye abruptamente cuando la temperatura de crecimiento aumenta de la temperatura ambiente a 423 K, luego se mantiene casi constante con mayores aumentos de temperatura, al final se produce un aumento brusco, que indica la superficie más rugosa de la película obtenida a 523 K de temperatura del sustrato.
En la tabla 3 mostramos los resultados obtenidos de la microscopia de fuerza atómica (AFM), donde se puede observar el comportamiento descrito anteriormente en las muestras obtenidas. Además se muestran los resultados de las alturas máximas promedios (Rpm) de los granos de las películas delgadas de TaN obtenidas por análisis de microscopia de fuerza atómica (AFM), en tres zonas diferentes tomadas al azar en el área superficial de cada muestra. De estos resultados se observa que con el incremento temperatura del sustrato desde 473 K a 573 K, la altura promedio de grano aumenta muy poco, permanece casi constante en este orden de magnitud, sin embargo, cuando aumenta hasta 673 K este crecimiento es muy brusco, tal como lo predice Hantechzadeh y Mortazavi (2012) [18], quienes encontraron el mismo comportamiento para temperaturas que van desde la temperatura ambiente hacia los 523 K que es cuando aumenta bruscamente.
TABLA 3 Altura máxima promedio (R pm ) de los granos de películas delgadas de TaN, tomadas en tres diferentes zonas de la superficie de las muestras sintetizadas a diferentes temperaturas del sustrato.

En la tabla 4 se muestran los datos obtenidos de la rugosidad media y cuadrática con el microscopio de fuerza atómica (AFM). Se observa claramente que la rugosidad cuadrática media varía con el incremento de la temperatura del sustrato. En estos resultados se evidencia que primero disminuye, permanece casi constante hasta cierta temperatura y luego aumenta bruscamente para cierta temperatura más alta.
Espesor e índice de refracción
Los espesores de las películas y sus respectivas velocidades de crecimiento se determinaron a partir del análisis SE (elipsometría espectral) mediante la cual se obtuvieron valores que se muestran en la tabla 5.
TABLA 5 Resultados de los espesores, velocidades de crecimiento, índices de refracción y coeficientes de extinción de las películas delgadas TaN obtenidas a diferente temperatura del sustrato por pulverización magnética reactiva DC.

En la figura 11 se muestra la gráfica del índice de refracción n y la gráfica del coeficiente de extinción k de las películas delgadas a temperatura 473 K, 573 K y 673 K en función de las longitudes de onda.
En la figura 11a, se observa que el índice de refracción n de las películas disminuye con el incremento de la temperatura del sustrato y por su parte en la figura 11b se observa que el coeficiente de extinción k de las películas que fueron sintetizadas a temperaturas de 473 K y 573 K, para el rango de 2000 Å a 5000 λ tuvieron el mismo valor, sin embargo la película depositada a 673 K disminuyó su valor de k; en el rango de 5000 Å a 12000 Å se observó que el coeficiente de extinción k aumenta para una temperatura de 573 K y disminuye para 473 K y disminuye aun mías para la película generada a 673 K, como se muestra en la tabla 5 para λ = 6000 Å. Este comportamiento del coeficiente de extinción k y los valores relativamente altos comparados con el de otros materiales altamente transparentes a la luz visible (como por ejemplo las películas delgadas de SnO, k = 0.015, λ = 6000 Å) [39], nos indica que las películas de TaN son altamente reflejantes en el rango de la luz visible, por lo cual presenta una superficie tipo espejo.
La figura 12 muestra la parte real e imaginaria del índice de refracción de la capa de TaN, a 673 K y se la compara con las gráficas correspondientes encontradas y reportados por Palik [40] y por Langereis [41]. Puede notarse que en la figura 12a la parte real de los datos de Langereis (línea a trazos de color negro) tiene mucha similitud con nuestra gráfica (línea continua roja) a partir de los 4000 Å hasta los 12000 Å. En cambio, la parte imaginaria de la figura 12b, de la gráfica de Langereis (línea a trazos de color negro) a partir de los 4000 Å tiene la misma forma que nuestra gráfica (línea roja continua), aunque son mayores los valores de los coeficientes de extinción k en las muestras obtenidas, significando que tendra una mayor absorción de luz. Esto significa que al aumentar la temperatura, las especies que arriban al sustrato tienen más movilidad que las menos calientes; esto ayuda a que se reacomoden en la capa en formation y la densidad aumente; al aumentar la densidad el promedio de huecos disminuye y la muestra se hace mas compacta; en consecuencia, el índice de refracción debería disminuir como en la figura 11a donde ya se evidencio este comportamiento, en el rango entre el espectro visible y el infrarrojo cercano (4000 Å - 12000 Å). Este comportamiento del índice de refracción es característico de las muestras metálicas, si fuera dieléctrico la parte real del índice ñ sería mayor en el ultravioleta decreciendo hacia la parte de los infrarrojos.
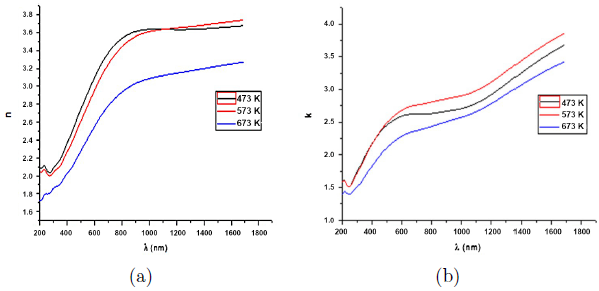
FIGURA 11 (α) Comparación del 'índice de refracción de las películas delgadas de TaN generadas a 473 K, 573 K y 673 K en función de la longitud de onda. (b) Comparación del coeficiente de extinción de las películas delgadas de TaN generadas a 473 K, 573 K y 673 K en función de la longitud de onda.
Conclusiones
De acuerdo a los resultados obtenidos en la parte experimental, queda demostrado que el incremento de temperatura del sustrato durante el proceso de síntesis tiene un efecto directo sobre la estructura cristalina, la morfología superficial, el índice de refracción y la rugosidad de las películas delgadas de TaN.
El crecimiento de las películas (cúbicas fcc) en diferentes direcciones cristalográficas es facilitado por efecto del incremento de la temperatura del sustrato, quedando evidenciado en los resultados XRD, en las cuales, se muestran que surgen nuevas direcciones cristalográficas, lo que sugiere que estas películas son de estructura policristalinas.
Å medida que se incrementa la temperatura del sustrato, el índice de refracción disminuye para longitudes de onda en el rango visible e infrarrojo cercano (4000 Å a 12000 Å); esto sugiere que en el proceso de crecimiento de las películas el reacomodo de las especies de átomos se debe al incremento de movilidad de las diferentes especies de átomos lo cual se debe precisamente al incremento de la temperatura del sustrato, por lo cual con este método logramos síntesis de películas delgadas de mejor calidad.
Los resultados del análisis SEM, nos demostro que la morfología superficial de las muestras prácticamente permaneció inalterable ante el incremento de la temperatura del sustrato y que el crecimiento de la película debe ser de forma columnar muy cerca de la superficie.
La rugosidad de las películas de TaN disminuyo a 573 K y luego aumento a la temperatura de 673 K debido al incremento del tamaño de grano. Se observó una disminución no muy grande en el tamaño de grano a ciertas temperaturas (473 K y 573 K), luego un incremento abrupto (673 K) lo cual nos sugiere que existen ciertos límites de temperatura del sustrato a las cuales, en lugar de disminuir el tamaño de grano crece abruptamente, lo cual hace que la rugosidad también tenga este tipo de comportamiento tal como se muestra en los resultados obtenidos.