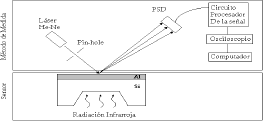 ]]>
Figura 1. Montaje desarrollado para la medida de la deflexión de la membrana de Si
]]>
Figura 1. Montaje desarrollado para la medida de la deflexión de la membrana de Si Figure 1. Experimental set-up to measure the Si membrane deflection
MEASURING TECHNIQUES FOR MANOEUVRES
JULIO DUARTE
Universidad Pedagógica y Tecnológica de Colombia Seccional Duitama, Boyacá, julioenriqued1@yahoo.com
FLAVIO FERNÁNDEZ
Universidad Pedagógica y Tecnológica de Colombia Seccional Duitama, Boyacá, flaviofm1@gmail.com
MAURICIO MORENO SERENO
Departamento de Electrónica, Facultad de Física y Química, Universidad. de Barcelona, España, moreno@el.ub.es
]]> Recibido para marzo 23 de 2008 aceptado junio 18 de 2008, versión final julio 17 de 2008
RESUMEN: La caracterización de dispositivos que tienen como principio físico la modificación de su estructura geométrica, tal como la deflexión de las membranas de Si, exige que sus deformaciones sean establecidas de una manera fiable y precisa. En este sentido, se hace un análisis de algunas técnicas de caracterización de sensores en uso actualmente. Las técnicas ópticas son las más analizadas, especialmente la técnica interferométrica, utilizada para caracterizar membranas neumáticas de Si construidas en el Centro Nacional de Microelectrónica, de la Universidad Autónoma de Barcelona, y caracterizadas en el Departamento de Electrónica de la Universidad de Barcelona, Barcelona, España.
PALABRAS CLAVE: Membrana, neumática, interferometría, infrarrojo, piezoresistivo.
ABSTRACT: The characterization of devices that have as a physical principle the modifications of their geometrical structures such as the silicon membrane deflection demands that their deformations must be measured in a reliable and precise way. In this sense, a study of some sensor characterization techniques used today is done. Optical techniques are emphasized, mainly the interferometric technique, which was used to characterize silicon membranes, that were manufactured in the Microelectronics National Centre at Universidad Auntónoma de Barcelona and tested at the Electronics Department at Barcelona University.
KEY WORDS: Membrane, pneumatic, interferometer, infrared, and piezoresistive.
1. INTRODUCCIÓN
Los sensores y actuadores de reducidas dimensiones, como acelerómetros, microbombas, micromembranas, piezoeléctricos, detectores de infrarrojos, etc, que presentan como principal característica el responder a una señal eléctrica y/o a una radiación de excitación, con una modificación de su geometría, son elementos que en los últimos años, y gracias al avance de la micromecánica y la mecanización del silicio, han venido a sumarse a los sensores y actuadores tradicionales. [1-12]
Estos elementos poseen unas características de control propias, por lo que su caracterización debe obedecer a alguna técnica fiable, factible y de costo razonable. Se ha considerado que realizar un sistema que permita la caracterización de dichos elementos, es del mayor interés, si cumple con los requisitos que una buena caracterización requiere. [13] La magnitud de la deflexión máxima que puede sufrir la membrana de silicio suele ser del orden de una decena de micras. El problema que aquí se plantea es la medida de la deflexión, la cual se puede realizar mediante diferentes técnicas, especialmente técnicas ópticas. Antes de describirlas, se introducirán algunos conceptos fundamentales del método de medida.
La deflexión de las membranas se consigue aplicando una diferencia de potencial a la resistencia interna y se utiliza como principio de actuación para la deflexión de las membranas mediante el calentamiento del aire en la cavidad (membrana neumática).[14] Las técnicas ópticas que se describen para medir la distribución de las deflexiones del sensor en forma de membrana micro-mecanizada son: la interferometría de Michelson, el método de triangulación óptica, el microscopio interferométrico y la interferometría por fibra óptica. [15-20] Los montajes ópticos se pusieron a punto midiendo la deflexión de una membrana termoneumática. Los resultados que se presentan se obtuvieron utilizando la interferometría de Michelson.
]]> elementos, es del mayor interés, si cumple con los requisitos que una buena caracterización requiere. [13] La magnitud de la deflexión máxima que puede sufrir la membrana de silicio suele ser del orden de una decena de micras. El problema que aquí se plantea es la medida de la deflexión, la cual se puede realizar mediante diferentes técnicas, especialmente técnicas ópticas. Antes de describirlas, se introducirán algunos conceptos fundamentales del método de medida.La deflexión de las membranas se consigue aplicando una diferencia de potencial a la resistencia interna y se utiliza como principio de actuación para la deflexión de las membranas mediante el calentamiento del aire en la cavidad (membrana neumática).[14] Las técnicas ópticas que se describen para medir la distribución de las deflexiones del sensor en forma de membrana micro-mecanizada son: la interferometría de Michelson, el método de triangulación óptica, el microscopio interferométrico y la interferometría por fibra óptica. [15-20] Los montajes ópticos se pusieron a punto midiendo la deflexión de una membrana termoneumática. Los resultados que se presentan se obtuvieron utilizando la interferometría de Michelson.
2. TÉCNICAS DE MEDIDA
Existen básicamente tres categorías de técnicas de medida que se pueden utilizar en la medida de pequeños desplazamientos: (a) Eléctricas: capacitivas, piezoeléctricas, piezoresistivas, de corriente túnel y microondas. (b) Magnéticas: Magnetización, magneto-elástica y de campo magnético externo. (c) Ópticas: Técnicas de espacio libre y técnicas de guía de onda que utiliza fibra óptica y dispositivos de óptica integrada [21].
Sin lugar a dudas, la tecnología láser es la que mayor precisión ofrece en aplicaciones metrológicas; en este sentido, se ha considerado partir de técnicas bien conocidas para poder establecer las mediciones adecuadas sobre cada tipo de microactuador. La utilización del laser es ventajosa cuando su potencia es suficientemente baja (del orden de 1 a 3 mW), ya que no se ve afectado el comportamiento del elemento sobre el cual incide el haz debido a que este puede focalizarse con gran presicion (siempre y cuando, claro está, que dicho elemento no tenga propiedades optoelectrónicas)
Entre las técnicas ópticas empleadas para la medida de desplazamientos submicrónicos la más conocida es la interferometría láser, la cual suele emplearse en la medida de espesores y análisis de superficie. [22-25] La interferometría proporciona precisiones por debajo de la longitud de onda del láser que se emplea, es decir, por debajo de 0.5 µm cuando se utilizan láseres dentro del espectro visible. No obstante, uno de los principales inconvenientes de las técnicas interferométricas es que proporcionan una medida indirecta del espesor o desplazamiento medido, ya que se deben contar el número de interferencias (máximos y mínimos) de la señal obtenida para establecer la distancia absoluta [26].
En este sentido y con objeto de simplificar el procesado de la señal obtenida es interesante emplear una técnica que proporcione una medida directa del desplazamiento del objeto. El método de sensado (o de medida) se refiere al proceso físico por el cual la respuesta de la estructura del sensor es sensada y cuantificada. La naturaleza del método de sensado puede ser óptica, capacitiva, piezoresistiva, etc.
Cualquier método de medida tiene configuraciones alternativas con diferentes grados de complejidad. Por ejemplo, en el sensor de desplazamiento que usa la interferometría láser en lugar de usar una óptica en espacio libre, se puede usar alternativamente fibra óptica u óptica integrada. Como parte del método de medida se incluyen todos los elementos que están involucrados en el proceso de sensar. Por ejemplo, en el sensor de desplazamiento de la Figura 1, el fotodetector, la fuente láser, y posiblemente un espejo sobre el diafragma, son considerados como los elementos del método de medida. Foto detector pinhole es un foto detector de defectos puntiformes (dispositivo fotoeléctrico que revela la presencia de agujeros sumamente pequeños y otras imperfecciones diminutas en un material en movimiento).
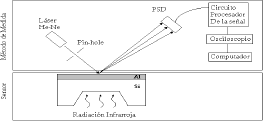 ]]>
Figura 1. Montaje desarrollado para la medida de la deflexión de la membrana de Si
]]>
Figura 1. Montaje desarrollado para la medida de la deflexión de la membrana de Si
Figure 1. Experimental set-up to measure the Si membrane deflection
Por ejemplo, se puede medir con un puente de impedancia, un oscilador controlado por un capacitor o un circuito de medida de carga. Algunos componentes eléctricos de esos esquemas suelen considerarse como parte del sensor ya que ellos son una característica particular de la técnica. Otros componentes como amplificadores, filtros, etc., son comunes a todos los esquemas y no se consideran como parte del sensor en sí mismo.
A manera de ejemplo esta técnica se ilustra en la Figura 2, la cual corresponde un sensor infrarrojo miniaturizado basado en el principio de la celda de Golay desarrollado en la Universidad de Osaka, Japón. A la izquierda aparecen los niveles de los que consta este prototipo y a la derecha se ve la sección transversal del dispositivo. El sensor consta de una cámara de gas y un capacitor plano paralelo.

Figura 2. Sensor infrarrojo y de gases basado en el principio de la celda de Golay [27]
Figure 2. Infrared and gas sensor based on the Golay cell principle [27]
En la figura 2 se observa que:
(1)
Siendo g la separación inicial entre los electrodos del condensador y w(x,y) la deformación de la membrana cuadrada de lado a. En este caso, las deflexiones de la membrana son del orden de 1 mm que producen variaciones de capacidad del orden del 10% frente a una capacidad inicial del orden de 30 pF. Si la cámara de aire se encuentra llena con un gas específico, tolueno o acetona en este caso, el sensor es sensible sólo a la presencia de ese mismo gas en el exterior. Si bien es menos selectivo, el mismo efecto se puede conseguir llenando la cámara de aire normal y ayudándonos de filtros interferenciales centrados en las bandas de absorción de los gases de interés. Una combinación de sensores de este tipo permitiría analizar una mezcla de gases.[28]
2.2 Técnicas PiezoresistivasUn estudio teórico del ruido en sensores capacitivos y piezoresistivos ha mostrado que para presiones idénticas a gran escala, y áreas de diafragmas pequeñas, los sensores piezoresistivos tienen el límite teórico más pequeño para la señal mínima detectable pero los sensores capacitivos muestran mejor estabilidad en periodos grandes, lo cual lo hace superior para algunas aplicaciones. Sin embargo, ambos tipos de sensores tienen límites en la resolución teórica por debajo de los valores experimentales. Una ventaja de este tipo de medida es que es tecnológicamente integrable con la cavidad. La desventaja que se puede plantear es que la electrónica necesaria para la lectura de la variación de la capacidad puede no ser inmune al ruido eléctrico. La Figura 3 muestra un sensor que combina las dos técnicas: capacitiva y piezoresistiva.

Figura 3. Sensor de presión piezoresistivo con actuación electrostática de la membrana ]]>
Figure 3. Piezoresistive pressure sensor with an electrostatically actuated membrane
La utilización de la fibra óptica presenta un valor añadido y es la posibilidad de efectuar medidas remotas. La fibra es meramente un medio para canalizar la radiación óptica hacia el sensor y de regreso hacia la electrónica de procesado, la cual puede realizarse en un ambiente libre de ruido eléctrico. Los límites fundamentales de un método de medida óptico son establecidos por la difracción y el ruido de disparo fotónico. En las técnicas ópticas se emplean diferentes tipos de fotodetectores, incluyendo los fotoconductores, los fototransistores, los diodos PIN, los fotodiodos de avalancha y los fotomultiplicadores.
Debido a que las técnicas ópticas fueron las seleccionadas para el desarrollo experimental con las membranas, en el siguiente apartado se detallan un poco más dichas técnicas.
2.3.1 Tiempo de vuelo y medida de fase
Son técnicas bien conocidas y aplicadas, sobre todo a grandes distancias. La técnica de tiempo de vuelo consiste en medir el tiempo de retraso entre un pulso de luz y el rebotado por el objeto a medir. A mayor potencia del pulso de luz mayor será la fracción rebotada por el objeto y que alcanza al telémetro (Figura 4). Pulsos de luz de unos cuantos vatios de potencia generados por diodos láser permiten efectuar medidas en el rango de kilómetros con precisiones del orden de metros. La técnica de la diferencia de fase es muy similar, donde se mide el desfase entre la señal moduladora del láser y la señal de retorno reflejada por el objeto. La frecuencia de modulación es inversamente proporcional a la distancia a medir; objetos a distancias del orden de metros necesitarían frecuencias de modulación de cientos de MHz.

Figura 4. Concepto de la medida de tiempo de vuelo y medida de fase
Figure 4. Concept of measuring the flying time and phase
2.3.2 Triangulación ]]> Es una técnica muy apropiada para rangos de distancias más próximos, entre centímetros y algunos metros. Según la geometría de la Figura 5, consiste en determinar la posición sobre un sensor de la proyección de un punto luminoso sobre el objeto, el cual requiere propagación en el espacio libre.

Figura 5. Geometría de un sistema de triangulación óptica
Figure 5. Geometry of a triangulation system
Entre las desventajas de la triangulación se tiene la no-linealidad, es decir, el movimiento del objeto en incrementos iguales, la posición de su imagen sobre el sensor no se mueve en incrementos iguales. No obstante, para rangos pequeños podemos considerarlo lineal.
Un haz láser colimado sale reflejado de la superficie de la muestra y se detecta usando un fotodetector pinhole. Asumimos que el haz láser colimado se refleja con un ángulo oblicuo desde la superficie de la muestra. Un espejo relativamente grande (más grande que la anchura del haz láser en la reflexión) se necesita si las dimensiones de la muestra son pequeñas comparadas con el diámetro del haz láser para evitar efectos de difracción indeseables.
2.3.3 Interferometría
La interferometría óptica es un fenómeno basado en la naturaleza ondulatoria de la luz que permite realizar medidas precisas de las formas o de las distancias, ya que proporciona una resolución extraordinaria y no requiere un contacto físico directo con la superficie sometida a estudio. Cabe recordar que la expresión matemática que describe la perturbación óptica es una ecuación diferencial parcial homogénea de segundo orden y obedece al principio de superposición. La interferencia óptica se puede decir que es una interacción de dos o más ondas de luz que producen una intensidad resultante, la cual se desvía de la suma de las intensidades componentes.
El principio fundamental de la interferometría consiste en la interacción o interferencia entre dos ondas luminosas que se encuentran una con otra, de forma parecida a lo que sucede cuando se encuentran dos ondas superficiales en el agua. En cualquiera de estos casos, cuando la cresta de una onda coincide con el valle de la otra, la interferencia es destructiva y las ondas se anulan. Cuando coinciden las dos crestas o los dos valles, las ondas ser refuerzan mutuamente. En la Figura 6 se observa que la interferencias e constructiva.
 ]]>
Figura 6. Principio de superposición. Cuando se presenta la interferencia, las ondas se suman constructiva o destructivamente
]]>
Figura 6. Principio de superposición. Cuando se presenta la interferencia, las ondas se suman constructiva o destructivamente
Figure 6. Superposition principle. If occurs interference waves add constructively or destructively
La interferometría se utiliza en ciertas aplicaciones de control de calidad y ha permitido reducir el coste y mejorar el funcionamiento de productos muy diversos, desde películas fotográficas hasta cintas magnéticas y disquetes.
La principal ventaja del Interferómetro de Michelson sobre las primitivas técnicas de producir interferencias es que los dos haces están ampliamente separados, pudiéndose variar la diferencia de recorrido ya sea moviendo uno de los espejos o introduciendo una sustancia refringente en la trayectoria de uno de los haces.
Los interferómetros pueden dividirse en dos clases:
Dentro de la gran cantidad de interferómetros de división de amplitud el más conocido de todos, e históricamente el más importante, es el Interferómetro de Michelson. Su configuración se ilustra en la Figura 7.
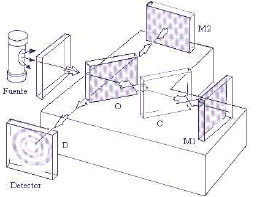 ]]>
Figura 7. Descripción de la interferometría de Michelson
]]>
Figura 7. Descripción de la interferometría de Michelson
Figure 7. Michelson interferometry description
Una fuente luminosa (la cual puede ser un láser o una placa difusora de vidrio esmerilado iluminada por una lámpara de descarga) emite una onda, parte de la cual viaja hacia la derecha. El espejo semiplateado (Un espejo semiplateado es semitransparente porque el recubrimiento metálico es muy delgado para ser opaco. Se puede ver a través de él y al mismo tiempo puede observarse por reflexión. Los divisores de haz, como se llaman estos dispositivos, se pueden hacer de películas de plástico delgadas estiradas conocidas como películas de placas de vidrio sin recubrir) en O divide la onda en dos, una parte viajando a la derecha y otra hacia arriba al fondo. Las dos ondas serán reflejadas por los espejos M1 y M2 y regresadas al divisor de haz. Parte de la onda que viene de M2 pasa a través del divisor de haz hacia abajo y parte de la onda proveniente de M1 es desviada por el divisor de haz hacia el detector. Por lo tanto, las ondas se unen y es posible que se produzca interferencia.
Obsérvese que un haz pasa a través de O tres veces mientras que el otro pasa una sola vez. En consecuencia, cada haz cruzará igual espesor de vidrio únicamente cuando una placa compensadora C se introduzca en el brazo OM1. El compensador es un duplicado exacto del divisor de haz con la excepción de un posible plateado o recubrimiento por una película delgada sobre el divisor de haz. Este último es colocado a un ángulo de 45° tal que O y C sean paralelas una respecto a la otra. Con el compensador en su lugar cualquier diferencia de camino óptico aparece de la diferencia de camino real. Además, debido a la dispersión del divisor de haz, el camino óptico es una función de λ. Para trabajo cuantitativo, el interferómetro sin la placa compensadora puede ser usado con una fuente cuasimonocromática. La inclusión del compensador niega el efecto de dispersión de tal modo que aún una fuente con ancho de banda grande puede llegar a generar franjas observables [31].
2.4 Descripción De Las Membranas
Figura 8. Membrana termoneumática
Figure 8. Thermoneumatic membrane

Figura 9. Vista superior (alúmina), vista inferior (silicio) ]]>
Figure 9. Top view (alumina), bottom view (silicon)
Para implementar el arreglo óptico se ha utilizado una membrana de silicio actuada termoneumáticamente cuyas dimensiones son: área 4000x4000 µm, 14 µm de grosor y una cavidad de actuación de 300 µm. Una resistencia dentro de la cavidad calienta el aire y luego expande la membrana. La resistencia es de Ta2N. Se aplicó una diferencia de potencial de 3v. A continuación se describe la membrana que se han fabricado y caracterizado de modo interferométrico y mediante otros métodos (triangulación e interferometría por fibra óptica).
Las membranas se han obtenido mediante ataque anisotrópico de obleas de silicio mediante KOH, se han construido en el Instituto de Microelectrónica de Barcelona (Centro Nacional de Microelectrónica). La Figura 10 muestra el abombamiento de la membrana causado por la temperatura, lo cual indica su sensitividad como respuesta al medio ambiente. Esta foto se tomó bajo las rejillas de un luminaria fluorescente y en ella se observa que los cuadros de la rejilla que coinciden con la región deformada de la membrana se hacen más grandes y distorsionados, mientras que los que se encuentran en la periferia se ven completamente normales.

Figura 10. Detalle del abombamiento de la membrana debido a la temperatura ambiente
Figure 10. Detail of the membrane deformation due to the ambient temperature
La Figura 11 es un diagrama esquemático del experimento. Comparando este montaje con el interferómetro de Michelson (Figura 7) se tiene que: la fuente es un láser de He-Ne, el detector es una cámara CCD, M1 es la membrana, M2 es el espejo y las lentes O y C forman el Beam Splitter.

Figura 11. Diagrama esquemático del experimento
Figure 11. Schematic diagram of the experiment
3. RESULTADOS
Para la medida del desplazamiento con respecto a la potencia aplicada a la resistencia calefactora se proporcionaron unidades de actuación constituidas por el substrato de silicio (con la membrana), la alúmina y la resistencia calefactora incluyendo los contactos eléctricos externos. La iluminación se hace con una onda monocromática de un láser de He-Ne con una longitud de onda de 0.633µm (633 nm). Un divisor de haces (el Beam Splitter) produce el haz de referencia y el haz test. Este último haz incide perpendicularmente a la membrana. La deflexión de la membrana produce una diferencia en el camino óptico el cual resulta en una diferencia de fase entre las ondas y se observan bordes oscuros y brillantes. Como se ilumina toda la superficie y cada punto de la membrana presenta una deflexión diferente, el resultado es una imagen bidimensional de interferencias que se pueden observar con una cámara CCD, como se muestra en la Figura 12.

Figura 12. Imagen de interferencia de la deflexión
Figure 12. Image of the interferente due to deflection
Los anillos aparecen desde el punto central debido a que éste tiene la mayor deflexión en cada instante de tiempo. La distancia entre dos bordes corresponde a λ/2 = 0.316µm, de esta manera obtenemos precisión del orden de las micras.
Los resultados de la medición de la deflexión de la membrana muestran imágenes de interferencia como en la Figura 12. La forma de los anillos se debe a que el punto de máxima deflexión está en el centro de la membrana. Estas imágenes se capturaron con una cámara CCD y se grabaron en un vídeo. Luego, con un sistema TV-Vídeo podemos contarlos y medir el tiempo de formación. La Figura 13 muestra la interpretación de datos numéricos de la deflexión de la membrana obtenida de la imagen de interferencia. En los primeros cinco minutos la formación de anillos ocurrió de dentro hacia fuera obteniéndose la curva con pendiente positiva. Inmediatamente después, la formación de anillos fue desde afuera hacia adentro y se obtuvo la curva con pendiente negativa. De la Figura 13 se puede obtener información de la deformación de la membrana, por ejemplo: la deflexión de la membrana de 19 µm con un tiempo de 60s y 31 µm con un tiempo de 120s.

Figura 13. Interpretación de los datos numéricos ]]>
4. CONCLUSIONES
Se han presentado un diseño experimental para la medida de la distribución de desplazamientos en una membrana termo-neumáticas. Al analizar la técnica descrita se pueden sacar las siguientes conclusiones:
En el interferómetro de Michelson se usaron: la visibilidad de los anillos de interferencia en función de la distancia entre las membranas y bombilla, al igual que la distancia entre las membranas y la fuente, para encontrar el desplazamiento.
Entre las ventajas que ofrece el interferómetro de Michelson se pueden destacar: realiza medidas dinámicas, se realizan estudios de superficies en 3-D (topografías) y es automatizable.
Las desventajas que presenta son: las superficies en estudio deben estar muy limpias, el banco óptico debe estar totalmente alejado de cualquier ruido o vibración mecánica posible ya que es muy sensible a este tipo de interferencias, proporciona medidas indirectas (conteo de anillos).
El método en el que se usó el interferómetro de Michelson es el que mejor se adapta a las condiciones experimentales que se encontraron el Departamento de Electrónica de la U. de Barcelona.
REFERENCIAS
]]> [1] EATON, W. & SMITH, J. Micromachined pressure sensors: review and recent developments. Smart Mater. Struct. 6, 530 539. 1997. [ Links ]
[2] HOLMES, D., GREEN, N. & MORGAN, H. Microdevices for dielectrophoretic flow-through cell separation. IEEE in Medicine and Biology Magazine 22, 85 - 90. 2003. [ Links ]
[3] HOUMMADI, L., CAMPITELLI, A. & WLODARSKI, W. Acoustic wave sensors: design, sensing mechanisms and applications. Smart Mater. Struct. 6, 647 - 657. 1997. [ Links ]
[4] KIM, J., VARADAN, V. & BAO, X. Finite element modeling of a smart cantilever plate and comparison with experiments. Smart Mater. Struct. 5, 165 - 170. 1996. [ Links ]
[5] REBELLO, K. Applications of MEMS in surgery. Proceedings of the IEEE 92, 43 55. 2004. [ Links ]
[6] CAJDA, M.A. Application of termal sisliconsemsor membranes. Sensor and actuators. 1-9. 1995. [ Links ]
[7] BAUER, M.F. Respuestas de placas elàsticas a exitaciones pulsadas. Journal Applied mechanics. 1968. [ Links ]
[8] MARCEL, J.E. GOLAY. A Pneumatic infrared detector.The review of Scientific Instruments. 357-359-361. 1947. [ Links ]
[9] ROSSEMBERG, D. Silicon micromachined sensor with tunable wavelenth selectivity for applicationin infrared spedtroscopy. Sensor and actuators. 413-416. 1995. [ Links ]
[10] BAUER, S. Inteference efects of thermal wave and applications to bolometers and piroelectrics detectors. Sensor and actuators. 417-421. 1991. [ Links ]
[11] YANG, Y. A thermally actuated micropump. Sensor and Actuators. 534. 1995 [ Links ]
[12] FRANS, J. A silicon microvalvule whit integrated flow sensor.. Pàg 313-316. Sensor and Actuators. 1995. [ Links ]
[13] DUARTE, J.E., FERNÁNDEZ, F.H., MORENO, M. Caracterización de microactuadores mediante técnicas ópticas. Revista de la Escuela Colombiana de Ingeniería. Año 15, 59. 35 38. 2005. [ Links ]
[14] VAN DE POL, F.C.M. A thermoneumatic actuation principle for a microminiature pump and other micromechanics devices. Sensor and Actuators. 139-143. 1989. [ Links ]
[15] BREEN, S. et al; Fiber optic displacement sensor with subangstrom resolution; Applied Optics; 29, 1990. [ Links ]
[16] BANK, D., SANDOVAL, F. Reflection and transmisión interference filtre. Journal Optical Society Physics. 451-465. 1947. [ Links ]
[17] THOUVENNIN. White light interferometric porfilometirc a power full technique for the control micromechanical devices deformation and fabrication. Mime`99 Gifsur Yvette France. 59-62. 1999. [ Links ]
[18] PUTMAN, C. A detalled of the analysis of the optical beam deflection technique for use in atomic force microscopy. Applied Physics. 6-11. 1992. [ Links ]
[19] OSAMU, T. Mechanical property measurement of thin films using load deflection Sensor and Actuators. 135-140. 1989. [ Links ]
[20] YAMA, K. Miniaturized infrared sensor using silicon diaphragm bases on golay cell. Sensor and Actuators. 29-32. 1998. [ Links ]
[21] TABIB-AZAR, M. et al. Sensing means and sensor shells: a new method of comparative study of piezoelectric, piezoresistive, electrostatic, magnetic, and optical sensors. Sensors and Actuators. 48 87-100. 1995. [ Links ]
[22] HILSUN, C. Infrared absortion of thin metal films. Journal Optical Society Physics. 188-191. 1954. [ Links ]
[23] CHEVRIET, J.B. An infrared pneumatic detector made by micromachining tecnoloogy. Micromechaning. 193-195. [ Links ]
[24] MARCEL J.E. GOLAY. The theoretical and practical sentivity of the pneumatic infrared detector The review of scientific instruments. [ Links ]
[25] TABATA, O., KAWAHATA, K. Medidas de propiedades mecanicas de película delgada utilizando cargar reflexion de membranas rectangulares. Sensor and Actuators. 135-141. 1998. [ Links ]
[26] DOMINGO, J., DUARTE, J.E., MORENO, M., PUIG- VIDAL, M. & SAMITIER, J. Caracterización automática de pequeños actuadores por láser. Proc. Seminario Anual de Automática, Electrónica Industrial e Instrumentación SAAEI`00, Cataluña, España, 253-256. 2000. [ Links ]
[27] YAMASHITA, K. Miniaturized infrared sensor using silicon diaphragm based on Golay cell. Sensor and Actuators. 29-32. 1998. [ Links ]
[28] GORAN, L.R. A new theoretycal model of the optoacustic gas concentration detector. Infrared Physics. 109-121. 1973. [ Links ]
[29] PANCEWIEZA, T. The empirical verfication of the fem model of semi conductor pressure sensor. Sensor and actuators. 260-265. 1999. [ Links ]
[30] MARCO S. Optimización de sensores de presión piezorresistivos de silicio para instrumentación biomédica y aplicaciones a alta temperatura. PhD. Dissertation, University of Barcelona, Barcelona, Spain. 1993. [ Links ]
[31] HECHT, E. et al. Óptica. Edición en Español del Fondo Educativo Interamericano, S.A., 305. [ Links ]
[32] CARMONA, M. Modelización y test de micromembranas: Aplicación a componentes de microfluídica. Tesis Doctoral, Departamento de Electrónica, Universidad de Barcelona, Barcelona, España, Mayo de 2000. [ Links ] ]]>